
韩国内存大厂 SK 海力士 (SK-hynix) 宣布,已经与 Xperi Corp 旗下的子公司 Invensas 签订新的专利与技术授权协议,未来将可以使用 Invensas 的 DBI Ultra 2.5D/3D 连结技术,使得目前在半导体发展上的两大发展领域-微缩 (miniature) 及异质整合 (Heterogeneous integration) 能获得更进一步发展。
SK 海力士表示,DBI Ultra 是一种专利的裸片,也就是在晶圆上借由混合键合的连结技术,使得在此裸片上达到每平方毫米的面积里容纳 10 万个到 100 万个连接开孔,孔间距最小只有 1 微米的大小,相比每平方毫米最多只有 625 个连结开孔的传统铜柱连结技术,新的技术可大大提高传输带宽。
另外,DBI Ultra 使用化学键合来连接不同的连结层,不需要铜柱和底层填充,因此不会增加晶圆的厚度,从而大大降低整体堆叠高度,预计可将 8 层堆叠提升到到 16 层堆叠,以获得更大容量。而且,在使用新技术制程的情况下,产品的良率因为不需要进行高温的流程,使得其产品的良率相较过去有更好的表现。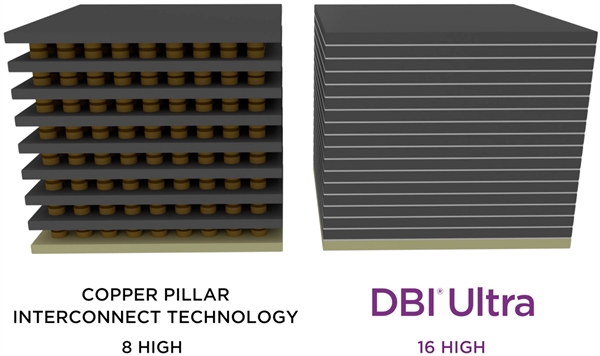
SK 海力士还强调,和其他下一代的连结技术类似,DBI Ultra 也同样支援 2.5D、3D 整合封装,还能整合不同尺寸、不同技术制程的 IP 模组。因此,不但可用来生产 DRAM、3DS、HBM 等内存,也可用于高整合度的 CPU、GPU、ASIC、FPGA、SoC 等产品的制造上。例如在 3D 整合解决方案上,在上方可以是 4 到 16 层堆叠的 HBM,下方则是连结了 CPU、GPU、FPGA、SoC 等逻辑运算单元。这对于未来在设计手持终端产品上,有大大节省空间的好处。
不过,目前 SK 海力士还未透露将会把 DBI Ultra 技术运用在什么样的产品上,但是依照市场的推测,以 SK 海力士的技术特长来说,显然用于 DRAM、HBM 上将会是最佳的选择。
(首图来源:Flickr/Kimber Jakes CC BY 2.0)







